先进封装厂商,抢占FOPLP。
马斯克宣布跨界进军先进封装领域,目标是FOPLP技术。旗下SpaceX公司也涉足半导体封装业务,计划在美国得克萨斯州建设自有FOPLP产能。值得注意的是,SpaceX的FOPLP封装基板尺寸将达到业界最大的700mm×700mm。日月光也投入了2亿美元采购设备,在高雄厂建立产线,计划于今年年底试产FOPLP。
先进封装意味着将不同种类的芯片,包括逻辑芯片、存储芯片、射频芯片等,通过封装和堆叠技术整合在一起,以提升芯片性能、缩小尺寸并减少功耗。现阶段的先进封装技术大致可分为三类:
倒装芯片(Flip Chip):这种技术将芯片倒置(有源面朝下)放置在基板上,并通过芯片上的凸点(Bumps)与基板实现电气连接。倒装芯片可以视为半个先进封装,一只脚踩在先进封装的门里,另一只脚还在门外,算是传统封装与先进封装的过渡产物。
2.5D/3D IC封装:在中介层上垂直堆叠各类芯片,从而缩小接点间距,减少所需空间及功耗。台积电的CoWoS便是此类技术的代表。
扇出型封装:与扇入型封装(Fan-In Packaging)不同,扇出型WLP中的RDL可以向外延伸布线,从而提升I/O接点的数量及密度。
因人工智能的火热,台积电的CoWoS技术一夜爆红。目前,依赖台积电CoWoS封装技术的芯片包括英伟达的A100、A800、H100、H800、GH200等型号。尽管如此,台积电的CoWoS封装产能依然吃紧。目前其CoWoS封装产能约为每月3.5万片晶圆,约占总收入的7%至9%。预计到2025年末,月产能将提升至每月7万片晶圆,贡献超过10%的收入。到了2026年末,月产能将进一步扩大至超过每月9万片晶圆。据统计,从2022年至2026年,台积电CoWoS封装产能的复合年增长率(CAGR)将达到约50%。
此前,台积电CEO魏哲家表示,公司将在今年持续增加CoWoS产能,以满足客户需求。预计2025年,CoWoS的全年营收贡献将从2024年的8%增长至10%。即便如此,台积电的CoWoS产能仍无法满足AI市场的全部需求。因此,除了扩充CoWoS产能外,半导体厂商也在积极寻找新的技术路线。
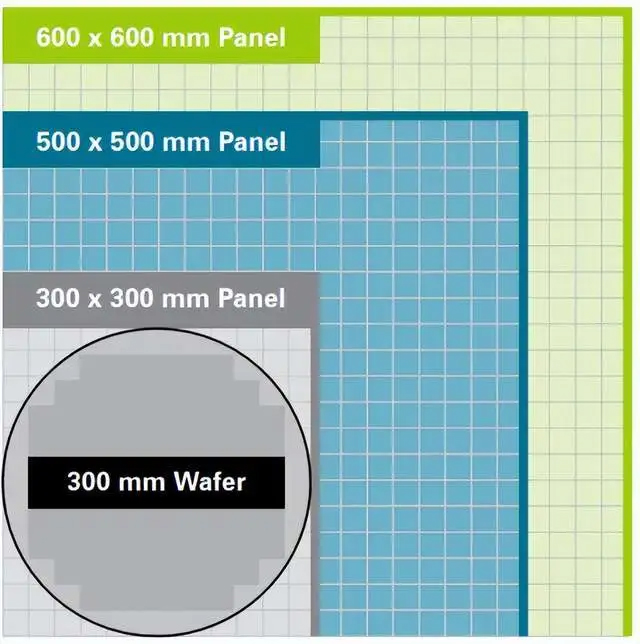
采用方形大尺寸面板显著提升了成本效益。举例来说,600mm×600mm尺寸的面板,其面积相当于12寸wafer carrier的5.1倍,因此单片产出的芯片数量大幅增加,从而提高了面积利用率。其次,FOWLP封装由于光罩尺寸小、曝光面积有限,需要多次拼接曝光,导致效率低下且良品率不高,影响整体产能。而FOPLP封装技术则实现了单次曝光面积大于FOWLP的四倍以上,显著提升了生产效率和良品率,进而大幅提升了产能。此外,FOPLP技术采用的玻璃载板材料也值得关注。考虑到FOPLP载板面积较大,在生产和处理过程中可能出现翘曲等问题,因此主要选用金属、玻璃或其他高分子聚合物材料代替传统硅材料。玻璃在机械强度、物理稳定性以及光学性能方面具有明显的优势,这也使得玻璃基板成为业内关注的焦点。目前,包括台积电、三星和英特尔在内的多家行业巨头均已布局玻璃基板领域。综上所述,凭借其出色的表现,FOPLP技术有望在未来先进封装领域打破CoWoS的垄断地位。
先进封装技术的快速发展令人瞩目。市场调研机构Yole在去年七月的报告中明确指出,受益于高性能计算(HPC)和生成式人工智能领域的强劲推动,先进封装行业预计将在六年内实现12.9%的复合年增长率(CAGR)。具体来看,这一行业的整体收入将从2023年的392亿美元增长至2029年的811亿美元,这一数字按当前汇率计算约合人民币5897.32亿元。

Yole预测,到2022年,FOPLP市场规模将达到约4100万美元,并预计在接下来的五年内将以32.5%的复合年增长率迅速扩张,至2028年,市场规模有望增长至2.21亿美元。三星早已在这一领域积极布局,其专为可穿戴设备设计的Exynos W920处理器,采用了先进的5nm EUV技术和FOPLP工艺。而谷歌的Tensor G4芯片也已采用三星的FOPLP技术。此外,AMD和NVIDIA等公司正携手台积电和OSAT供应商,计划将FOPLP技术融入其下一代芯片之中。
台积电亦在小基板上积极探索。2024年8月,台积电发布公告称,将斥资171.4亿元新台币收购群创在南科的厂房及其附属设施。台积电CEO魏哲家公开表示,公司正全力推进FOPLP工艺技术的研发,并规划建立小规模试产线,目标是2027年实现量产。初期,台积电选择了尺寸较小的300×300 mm面板,并预计在2026年完成miniline小规模产线的建设。值得注意的是,尽管台积电曾倾向于采用515×510 mm的矩形基板,这一尺寸相较于传统12英寸圆形晶圆,可用面积可增加三倍,但台积电后来又尝试了600×600 mm和300×300 mm的规格,最终决定初期先采用300×300 mm进行试产,待技术成熟后再扩展至更大尺寸。
日月光则在十年前便开始布局FOPLP领域。营运长吴田玉在今年2月表示,公司计划在高雄厂区投入2亿美元(约新台币66亿元),设立面板级扇出型封装(FOPLP)量产线,预计第二季度设备进厂,第三季度开始试量产。日月光最初采用300mm×300mm规格进行研发,并在取得良好效果后,将尺寸推进至600mm×600mm,并于去年开出设备采购单,相关设备预计在第二季度和第三季度装机,年底开始试产。若试产顺利,明年即可通过客户验证并实现量产出货。吴田玉相信,一旦600mm×600mm面板级扇出型封装的良率符合预期,将有更多客户和产品采用这一技术,进而成为业界主流规格。这一技术的应用也将有效解决现有12寸晶圆尺寸无法满足需求的问题。
力成科技作为全球封测厂商中的先行者,早在2016年便建立了第一条FOPLP产线,并于2019年正式投入量产,其规格为510*515mm。位于新竹科学园区的全自动FineLine FOPLP封测产线,已经开始小批量出货,进一步巩固了力成科技在这一领域的地位。





